《半导体器件的失效机理和模型》将针对硅基半导体器件常见的失效机理展开研究。这些失效机理大致按照从硅到封装器件的半导体生产工艺流程进行了分类:前段制程(FEoL)、后段制程(BEoL)和封装/界面失效机理。注:失效机理研究只包括那些业界相对成熟,同时还包括这些失效机理的模型研究现状。内容主要来源为国内外文献的翻译整理,供大家学习参考。
各阶段常见的典型失效机理
1)与时间相关的电介质击穿(TDDB)-- 栅极氧化物
1)与时间相关的电介质击穿(TDDB)-- low k材质电介质/移动铜离子
本文对离子迁移动力学(PCB)--组件清洁度进行研究 在器件或PCBA制造过程中,每一步均会对产品的表面污染产生影响。在器件或PCBA上发现的离子残留量主要可归因于外部湿化学处理步骤。在集成电路模塑封装工艺之后,引脚电镀和冲洗步骤对引脚组件清洁度的影响最大。 通常,引脚电镀的湿化学工艺为先采用甲磺酸(MSA)电解质标准进行锡和锡铅表面处理的镀覆,然后采用一个碱性中和步骤使酸发生反应,最后进行水洗清洁。这种湿化学工艺是决定集成电路组件清洁度的关键因素,如果甲磺酸(MSA)或者碱性中和剂未能完全去除,这些残留物将会引发漏电和电化学迁移腐蚀问题。 一个甲磺酸未完全去除导致的键合丝腐蚀案例《甲磺酸残留导致键合丝腐蚀案例》。
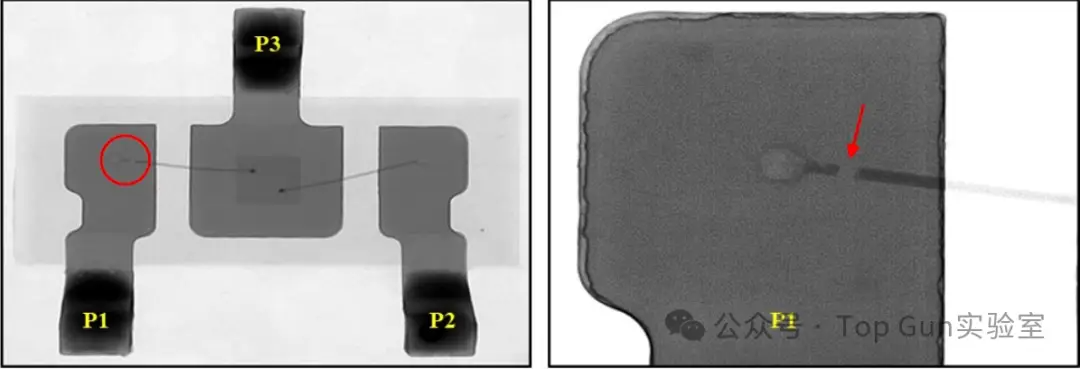
大多数文献是基于现象学而非基于模型的研究。然而,已发现一些数据支持银(Ag)和钼(Mo)迁移与温度相关的阿伦尼乌斯(Arrhenius)模型。按照常理,大家预期离子迁移率与电场或电压存在关联,但获取相关数据却颇具难度。

计算加速条件下和正常使用条件下的银离子迁移率加速因子(AF)。
1)正常使用条件为:50°C
AF=exp[(Eaa/k)(1/Toffice–1/Taccel)=exp[(1.12eV/8.62x10–5eV/K)(1/(273+50)K–1/(273+60)K)]=3.3
结论:由于温度差异,从加速环境转移到正常使用环境,AF为3.3倍。
按照IPC TM 650.2.3.28测试方法,通过离子色谱法在产品上发现的典型污染物有:甲磺酸(MSA)、氯化物、溴化物、硫酸盐、磷酸盐、钠和氨。当这些污染物中的任何一种或者总体组合含量较高时,在环境温度和湿度条件下,带电组件就会出现高漏电和电化学迁移问题。因为这些离子污染物在潮湿空气中以离子形式存在,具有极性,会在线路板上引起电化学效应(如果同时有电子存在的话)。注:由于它们不能通过目检发现,所以这种潜在危险尤其需要重视。这些离子污染物主要来源于电镀、波峰焊、回流焊和化学清洁等工艺,如助焊剂残留、电离表面活化剂、乙醇、氨基乙醇和人体汗液等污染形式。 由于目前PCBA行业60~75%采用免清洗组装技术方法,采用免清洗组装工艺时,不会在组装后进行清洗以去除任何有害残留物,所以元器件清洁度比以往任何时候都更为关键。如果元器件腐蚀性/吸湿性残留物含量高,那么在焊接操作之后,这些残留物的含量仍然很高。
引用参考:
1、离子清洁度测试方法:离子清洁度常用的测试方法
2、样品离子清洁度判定方法:离子清洁度判定方法
3、离子清洁度典型案例:典型案例